应用材料加速半导体产业实现异质整合技术蓝图
应用材料发布新技术与能力,帮助客户加速实现异质芯片设计与整合的技术蓝图。应用材料结合先进封装与大面积基板技术,与产业合作伙伴携手开发新解决方案,大幅改善芯片功率、效能、单位面积成本与上市时间(PPACt)。
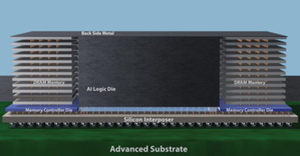
应用材料公司加速异质的设计和整合
异质整合让不同技术、功能与尺寸规格的芯片得以整合在一个封装中,让半导体与系统业者获得前所未有的设计与制造弹性。应用材料公司是全球最大的先进封装技术供货商,产品线囊括蚀刻(ETCH)、物理气相沉积(PVD)、化学气相沉积(CVD)、电镀(ECD)、化学机械研磨(CMP) 、表面处理与退火。应用材料公司位于新加坡的先进封装研发中心,拥有业界最广泛的产品组合,能为异质整合奠定稳固根基,包括先进凸块、微凸块、细线重布线路层(RDL)、硅穿孔(TSV)与混合键合(Hybrid Bonding)。
针对异质整合先进封装技术,应用材料公司发布了三项至关重要的创新,包括裸晶对晶圆混合键合、晶圆对晶圆迭合与先进基板。
加速裸晶对晶圆的混合键合
裸晶对晶圆混合键合使用铜对铜直接互连技术,提高I/O密度并缩短小芯片之间的线路长度,进而提升整体效能、功率与成本效益。为加速此技术的开发,应用材料公司在其先进封装研发中心新增了先进软件仿真功能,在进入硬件开发阶段前先行评估与优化各种参数,例如材料选择与封装架构,协助客户缩短学习周期与产品上市时间。这些是应用材料公司与贝思半导体 (BE Semiconductor) 在2020年10月发布的共同开发协议中提到的功能。此协议的目的是率先为裸晶型混合键合技术,提供完整且获产业认可的设备解决方案。
贝思半导体技术长Ruurd Boomsma表示:「透过与应用材料公司合作,我们对协同优化设备解决方案有更深入了解。这些解决方案能帮助客户在晶圆生产环境中,运用复杂的混合键合制程,在极短的时间内,贝思半导体与应用材料公司团队已在新加坡混合键合卓越中心取得显著进展,不仅能更有效率地处理客户材料,同时也加速先进异质整合技术的发展。」
为晶圆对晶圆混合键合开发协同优化的解决方案
晶圆对晶圆接合技术,能让芯片制造商在单一晶圆上设计特定芯片架构,并在另一片晶圆上设计不同的架构,再藉由这两片晶圆的接合,制造出完整的装置。为了达到高效能与良率,前段制程步骤的质量非常重要,接合时的均匀度和对准度也不容轻忽。因此,应用材料公司同时也宣布与益高科技(EVG)签订联合开发协议,共同为晶圆对晶圆接合开发协同优化的解决方案。这项合作将结合应用材料公司在沉积、平坦化、植入、量测与检验领域的专业能力,以及EVG在晶圆接合、晶圆前置处理与活化,以及接合对准和迭对量测方面的顶尖技术。
EVG业务开发总监Thomas Uhrmann表示:「3D整合与工程设计材料逐渐成为半导体创新的驱动力,并带动晶圆对晶圆混合键合技术的需求。若要优化此关键制程技术,以因应新应用的需求,首先要对整个制程链的整合议题有透彻了解,透过与业界伙伴合作,例如与应用材料公司建立的合作关系,我们可以与制程设备公司共享资料,并学习对方的长处,进而协同优化我们的解决方案,更有效地解决客户在制造方面的重要问题。」
应用材料公司先进封装业务开发总经理文森特‧ 迪卡普里奥(Vincent DiCaprio)表示:「透过与贝思半导体和EVG等产业伙伴的合作,应用材料公司能为客户提供所需的专业能力与技术,以加速裸晶对晶圆、晶圆对晶圆混合键合技术的开发与采用,随着愈来愈多芯片制造商使用异质整合技术来实现PPACt目标,应用材料公司期待能在这个生态系统中做出更多贡献。」
利用更大面积、更先进的基板获得PPAC优势
由于芯片制造商不断在精密的2.5D与3D封装设计中植入更多芯片,使得更先进基板的需求与日俱增。应用材料公司也运用最近收购的Tango Systems提供的先进面板制程技术,来增加封装尺寸与互连密度。相较于晶圆尺寸的基板,500 mm2以上的面板尺寸基板能够封装更多芯片,进而提升芯片的成本效益、功率与效能。
随着客户开始采用这些较大面板尺寸的基板,应用材料公司也透过旗下的显示器事业群提供大面积的材料工程技术,包括沉积、电子束测试(eBeam testing)、扫描式电子显微镜(SEM)检测与量测,以及针对缺陷分析的聚焦离子束(FIB)。





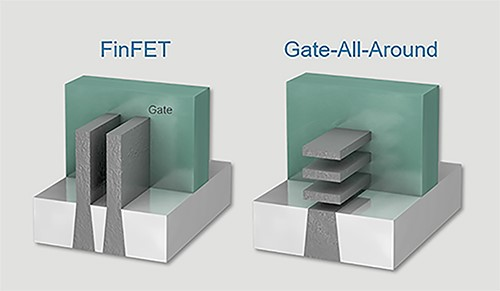

评论