但是BGA返修台价格一直居高不下,主要是生产都不成规模成本高。
然而去做维修这一行业的多数都是穷苦人家,开店初期除了房租外再额外添置这一设备经济压力一定不小。
今天为朋友提供一个比较容易实现且比较靠谱的组合
BGA返修台的精华所在就是上下温区和温控检测,只要实现这几项就得到了基本的BGA拆焊功能
方案:
上温区:安泰信AT8205 柔和旋转风
下温区:安泰信AT853A
温度检测仪
支架台
各地价格不同,基本成本在500元以内可实现。

图是初次测试效果,完美拆下IBM 收银机 主板南桥
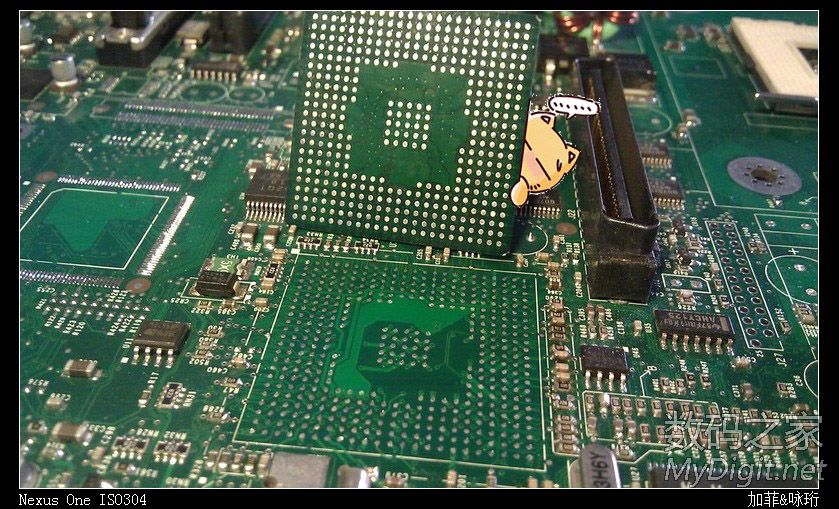
BGA返修台的加热升温是智能控制的一个曲线,所以有必要了解BGA返修台的工作温度和原理。
在BGA返修或BGA焊接过程中,焊接温度曲线是一个重要的变量,它对BGA返修台的成功率有很大的影响,特别是返修后的稳定性更是致命的。返修过程中的温度和加热时间是焊接温度曲线的两个变量。对于不同的电路板和不同的助焊剂(焊膏),这里推荐使用美国AMTECH焊膏,焊接温度曲线是不同的。
BGA返修温度曲线主要分如下几个调整温区:
一、预热区。
温度是30℃至175℃,通常建议使用的升温速度是每秒2℃至3℃,以避免对容易受温度影响的元件(例如,陶瓷片状电阻器)造成热冲击。
这个建议太保守,因为同样的电容器是用波峰焊,在焊接过程中,它们的预热温度大约是从120℃,温度上升到焊锡槽中的260℃也不会出现什么问题。所以使用每秒5℃的速度同样是安全的。
保温区。
在这个温区,电路板达到温度均匀。在这个温区,温度上升速度缓慢,温度从175℃上升到220℃,温度曲线几乎是平的。保温区也起到焊膏的助焊剂活化区的作用。长时间保温的目的是为了减少气泡,尤其是对于球栅阵列(BGA)封装器件,在保温区温度过高的后果是焊膏过分氧化而导致出现锡珠,焊膏会溅出来。不使用保温区,但把温度平稳地从预热区升高到峰值再流温度,这也是一个普遍的做法。然而,当温度逐步提高到峰值再流温度时,焊接可靠性会降低许多,为以后带来新的返修隐患。
再流区。
这个温区,如果温度太高,电路板有可能会烧伤或者烧焦。如果温度太低,焊点会呈现灰暗和粒状。这个温区的峰值温度,应该高到足以使助焊剂充分起作用,而且湿润性很好。但它不应该高到导致元件或者电路板损坏、变色或者烧焦的程度。对于无铅焊接,这个温区的峰值温度应该是230℃至245℃。焊锡融化成液态以上的时间应该保持30秒到60秒。温度高于液态的持续时间过长,会损坏易受温度影响的元件。它也会导致金属间的过度化合,使焊点变得很脆,降低焊点的抗疲劳能力。
冷却区
再流之后焊点的冷却速度也很重要。冷却速度合理,焊料结晶粒度越小,抗疲劳能力越高。
最后就是在返修过程中所有四个温区整块电路板的温度均匀,在5℃至10℃之内,适当提高整板的温度对于焊接成功率和可靠性是一个很好的方法,这也是BGA返修中极为重要的。LPB-2016 BGA返修台可以存储12个温度数据组,可以有效减少维修人员温度调节工作量。
所以使用上述内容后我们这个方案里的温度曲线存储在我们的大脑里,手动实现。
下面介绍这个组合方案的使用(初步摸索,高人们多多交流经验。)
这里要注意重要的一点,我们设置的温度和实际检测出来的温度不是一致的,要低一些的。
我们这里说的温度是温度旋钮设置的温度,检测的温度会注明。
总的来讲下温要比上温高30度左右。有铅焊锡熔化温度大约185℃左右,无铅焊锡熔化温度大约220℃左右。
测温线探头放置在芯片下方缝隙略微探入不碰到锡点为宜。
前期准备:1芯片周围用锡箔纸覆盖,背面如果有元件也需要覆盖。
2给芯片加助焊剂,从芯片一侧涂抹,在用风枪100度加热芯片是助焊剂流入到芯片底部,从另一侧流出为止。
预热、
下风853A打开工作温度是100,由于距离较远,实际到达主板上的温度在70-90左右。
上风AT8205打开工作温度是50,通过大风嘴到达芯片的温度在35-45左右。
预热阶段下温保持最低100,上温从50缓慢调整到125,看测温表从室温逐渐升温到100度左右
此过程使用2分钟的时间完成,斜率是很缓的,原因不再复述。
升温、
预热阶段结束后随即进入升温阶段,温度旋钮每升高50度分成至少10次以上来调整。
测试要关注测温表的跳变速度,控制在1-2摄氏度每秒。直到测温表的读数高于所使用焊锡熔化温度15-25度左右
有铅:210到225左右,无铅230到240左右
我测试时下温旋钮在不到300,上温旋钮在不到325,此时测温表显示235左右跳变(仍缓慢升高)
恒温、
此阶段就是调整旋钮使实际温度保持在235到240之间(无铅)约60到80秒,
熔焊、
用镊子轻触芯片一侧中间位置,要多轻有多轻,看到芯片移动又回弹回来。证明焊锡已经完全熔化。
A:此时如果是加焊操作就大功告成了,把上下温度旋钮调至最小,关闭下风853的加热开关和上风的电源开关,
会进入冷却阶段,等8205自动停止后关闭下风电源。即可
B:如果是取下芯片重新植锡,这是确定回弹动作后用吸笔取下芯片后按A降温继续。
